联付宝pos机人工客户服务电话
2024-04-18 10:22:42
������pos���ͷ��绰:������鿴�ͷ��绰���˹��ͷ��绰:������鿴�ͷ��绰������ʱ����:����9:00-����21:00����������,Э�̻���,��ǰ���������������������
�ߴ����洢����������(neng)��(ji)����������ĺ�(he)�� ��(liang)��(nian)ӭ���ڼ�������(shi)������ح�ƽ���,�ڴ�,оƬ,����
HBM���ߴ����洢������һ(yi)�������ڴ����������ƿ����AIоƬ��չ�ؼ�(jian)���ڣ�����(zai)Ӣΰ����Ʒ�����侰�£��������������
HBM��ʲô��
HBM��High Bandwidth Memory�����ߴ����洢�����ǻ��ڹ�ͨ�ף�TSV����(tu)��(dian)��Microbump�����������DRAMdie��Logicdie�ѵ�(die)����(cheng)�ľ���(you)��ά���ֵĴ洢��Ʒ��
GPU�������洢��(ji)��(hua)Ŀǰ��(you)GDDR��HBM��(liang)�֡�����(zai)�롤ŵ������(ji)�����ϵ�����У�������(zai)�š��ڴ�ǽ���͡�����ǽ����(wen)��(ti)�����ڴ�(chuan)ͳ�Դ�GDDR5�����Ŵ����͡����ĸߵ�ƿ����HBM����(neng)����3D��(feng)װ�������(cheng)DRAMdie�Ĵ�ֱ��(fang)��ѵ�(die)��(feng)װ����(neng)������̶Ƚ�Լ�洢оƬռ��(you)�����(ji)�����(cheng)���ߵļ���(cheng)�Ⱥ���洢������
����(zai)��(chuan)���ٶȷ�(fang)�棬����TSV������(neng)������(zai)�洢оƬ��(shang)��������ڴ�ͨ�����Ҹ�����(cheng)��ʹ��HBM�ʹ�����֮����������������̣����HBM����(zai)λ���������ȹؼ�(jian)����(neng)��(shang)����������GDDR������SAMSUNG��3DTSV���սϴ�(chuan)ͳPOP��(feng)װ��ʽ��ʡ(sheng)��35%�ķ�(feng)װ�ߴ磬������50%�Ĺ��ģ����Ҷ�(dui)�ȴ�����8���Ĵ�����������(you)Ч��(ban)�����ڴ�ǽ��(wen)��(ti)����ǽ��(wen)��(ti)����(cheng)Ϊ��ǰ����(yi)AI�������ü�(ji)��(hua)��������(you)����AIоƬ���á�

������Դ����AnOverviewoftheDevelopmentofaGPUwithintegratedHBMonSiliconInterposer����IEEE
HBM�ѳ�(cheng)Ϊ������(neng)��(ji)����������ĺ�(he)�ġ�
Ӣΰ��������(zai)2019��(nian)�����Ƴ���(zhen)��(dui)��(shu)�����ĺ�HPC������רҵ��GPUTeslaP100����ʱ�ųơ��ر���ǿ���IJ��м�(ji)�㴦������DGX-1��(ban)�������ǻ��ڵ�(dan)��8��(ka)TeslaP100GPU��������(cheng)�������ڲ��ô���16GB��HBM2�ڴ棬TeslaP100��������720GB/s����ͬһ(yi)ʱ���Ƴ���ͬ������Pascal�ܹ���GTX1080������GDDR5X�ڴ棬����Ϊ320GB/s��
���Ӣΰ����(shu)�����ļ��ټ�(ji)��GPUV100��A100��H100������HBM�Դ档���µ�H100GPU����HBM3�ڴ棬����80Gb��������3Tb/s��Ϊ��(shang)һ(yi)������HBM2�ڴ�A100GPU����(liang)����
����Ϊ���ټ�(ji)�㷶�����ߵ�AMD��(dui)��HBM�����ø�Ϊ�����������·�����MI300XGPU���������ߴ�192GB��HBM3�Դ棬ΪH100��2.4�������ڴ������5.2TB/s��ΪH100��1.6����HBM����(cheng)ΪHPC���������ĺ�(he)�ġ�
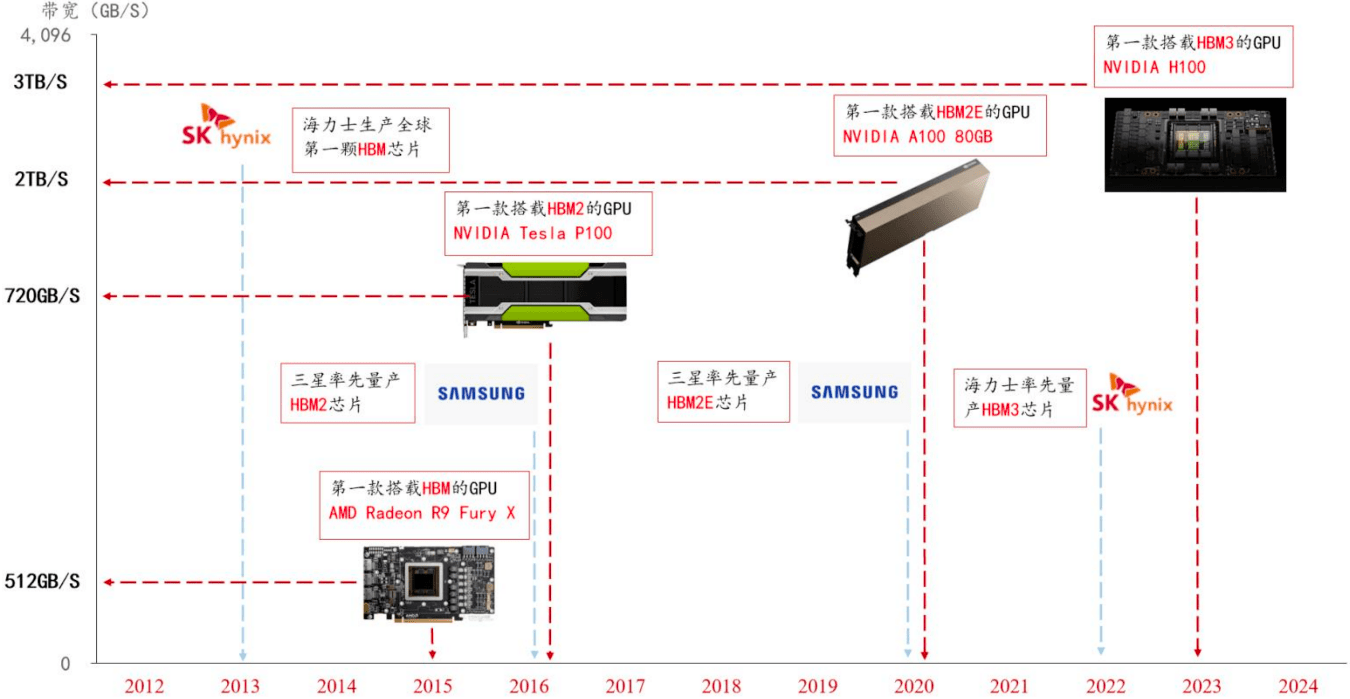
����HBM��Ʒ����������ʱ���߲�����Դ������˾��������ֱ���ӻ���
��Ʒ������HBM��(re)�Ƚ�һ(yi)�����ӡ�
��(jin)�ڣ�Ӣΰ�����һ(yi)��AIоƬH200�����ǵ�ǰ����ѵ����ʼ������(yu)��(yan)ģ��H100оƬ�Ľ�����Ʒ�������ó�(chang)��������������HBM3e��Ӣΰ��H200��ÿ��4.8TB���ٶ��ṩ141GB���ڴ棬��A100���⣬��������������(liang)��������������2.4����Ԥ��(ji)��2Q24����(huo)���ݺ�(han)ýbusinesskorea������2023��(nian)���������ǵ��Ӻ�SK��(hai)��ʿHBM����(dan)һ(yi)ֱ����(zai)������
��(shi)���ռ���(you)���
Ŀǰ��ѵ�����������ڴ��������������(chang)�����Ѷ˼���(bian)Ե����������(chang)��������(zai)��HBM��(shi)���ռ䡣
��(cong)��Ǯ������(kan)��HBM��ƽ���ۼ�������DRAM����������ǰ��ChatGPT������ͬʱ����(xian)����(neng)����HBM�ļ۸�һ(yi)·�µ���������(neng)��ߵ�DRAM����HBM3�ļ۸��µ����屶���߶�AI��(ban)����GPU����HBMоƬ�ѳ�(cheng)������
����TrendForce��2022��(nian)����(qiu)HBM����ԼΪ1.8��GB��2023��(nian)����(chang)Լ60%����2.9��GB��2024��(nian)��������(chang)30%����ֱ֤ȯ(quan)�۵�(dian)��Ϊ����HBMÿGB�ۼ�20��(mei)Բ���㣬2022��(nian)����(qiu)HBM��(shi)����Χ(wei)ԼΪ36.3����(mei)Բ��Ԥ��(ji)��2026��(nian)��(shi)����Χ(wei)����127.4����(mei)Բ����(dui)ӦCAGRԼ37%��

����(qiu)HBM��(shi)����Χ(wei)������(mei)Բ��������Դ��TrendForce����˼����
������ѯ��¶���֣�2023��(nian)����������HBM2eת��HBM3���������(zhong)Ԥ��(ji)���Ϊ50%��39%��2024��(nian)��(shi)�������ת��HBM3��HBM3����(zhong)Ԥ��(ji)��60%������HBM3ƽ�����۵�(dan)��Զ����HBM2e��HBM2����˽�����ԭ��HBM����Ӫ������(chang)����(you)����һ(yi)����Ա2024��(nian)ȫ��HBMӪ����89����(mei)Բ��ͬ������(chang)127%��
Ŀǰ����HBM��(shi)��������(fen)���µĿ�ʽ������SK��(hai)��ʿ�������ȣ�����/��(mei)�������
SK��(hai)��ʿ��ǰ�������ȣ���(he)������(zai)��MR-MUF������MR-MUF��(neng)��(you)Ч��ߵ���(re)�ʣ������ƹ����ٶȺ����ʡ�SK��(hai)��ʿ��2021��(nian)10�����ȷ���HBM3��2023��(nian)4�¹�˾���(cheng)�˻���(qiu)�״�12���ͨ������ֱ�ѵ�(die)оƬ����������24GB������(shang)һ(yi)��HBM3�߳�50%��SK��(hai)��ʿ���(ji)����(zai)2023��(nian)��β������HBM3E��Ʒ������2024��(nian)��������˾Ŀ��(biao)2026��(nian)����HBM4��
��������(you)���ں�(han)Ԫ�½���(feng)װ�ߣ�Ԥ��(ji)25��(nian)����HBM4��ΪӦ��(dui)HBM��(shi)�����������ǵ����Ѵ�(cong)������ʾ(shi)��SamsungDisplay���ɰ�(ban)�찲�����ڲ���(fen)��(xiu)������豸�����ڷ�ֲ��HBM��(feng)װ�ߣ���Ͷ��(zi)���7000-10000�ں�(han)Ԫ������Ԥ��(ji)������(zai)2023Q4��ʼ����(mei)�ͻ���ӦHBM3��
��(mei)��������(zai)2024��(nian)����HBM3E�������Ʒ�з��С���(mei)������(zai)��ǰ�IJ�(cai)���绰������(shang)¶���ֽ�����(zai)2024��(nian)����HBM3E���(cheng)��Ԥ��(ji)��HBM3E����2024Q3���(gai)Q4��ʼΪӢΰ�����һ(yi)��GPU��Ӧ��11��6����(mei)������(zai)̨(tai)��̨(tai)���ij���ʽ����������������(cheng)�ȱ���̽��ͷ�(feng)װ���Թ�Ч������HBM3E�Ȳ�Ʒ��
������ҵʱ������(zai)���
HBM��ҵ����Ҫ(yao)��IP���������ϡ��������(ji)��������Ƭ��������(feng)װ����Ե���ڽM��(cheng)��
����DRAM������Ӧ����Ҫ(yao)����Ϊ���ǡ���(hai)��ʿ����(mei)�⣬оƬ�������(feng)װ������Ҫ(yao)Ϊ����(you)CoWoS������̨(tai)��(ji)�硢I-Cube���������ǡ�EMIB������Ӣ�ض��Ⱦ���(you)2.5D/3D��(feng)װ������Foundry/IDM���̣����Է������ɴ�(chuan)ͳ��(feng)װ���Գ�����(ru)���¹⡢Amkor��ռ��(you)��
����(zai)IP���ڣ���AMD������˼��IC���(ji)������(wai)��������˼�Ƽ����滪��(ji)�����Rambus��̨(tai)�崴��(yi)��IP���̶��ṩHBMIP��(ban)����(ji)��(hua)������(qiu)���IP����Arm��δ�ṩ��ذ�(ban)����(ji)��(hua)��
���ڳ�������Ҫ(yao)�����������ϺͰ뵼���豸���롣
������(you)�̾�����(lao)�����������˾�Թ̾���ҵ��Ϊ������չ�����ͷ�(fen)ѡ�豸����ͨ��(fu)�硢����Ƽ�����ܿƼ��ȿͻ��������ܡ������ڷ�(feng)װ�����ĵ�������(dui)�̾����ȵ�Ҫ(yao)���������ߣ�ͬʱHBM�ߴ�������������(jian)������(cong)��bump��TCB/��(hun)����(jian)�ϣ��ƽ��̾�����̾�����(dan)�����������ֵ��ע��(yi)���ǣ�2021��(nian)��(feng)���豸�еĺ����̾����������ʽ�3%����������ռ��(guang)����
���Ի�����(fen)ѡ����(fang)����(you)��(chang)���Ƽ���2023��(nian)���(cheng)��(chang)�ȿƼ���(zi)��������ʹ�ù�˾�ֳ�(cheng)���뼯��(cheng)��·��(fen)ѡ�豸���룬���(cheng)��(zhong)��ʽ��(fen)ѡ����ƽ��ʽ��(fen)ѡ����ת��(ta)ʽ��(fen)ѡ���IJ�Ʒȫ���ǡ�
���(cheng)�Ƽ������ȱ���(feng)װ���(du)Һ����ߣ���Ϊ�ȱ���(feng)װ�ʹ��е�һ(yi)��(dan)Ʒ�ĵ��(du)Һ���ѽϴ�(chuan)ͳ��Ʒ��ֵ��������������(shang)��3D��(feng)װ��TSV�����ʼ�����������Vantage Market Researchչ����TSV��(shi)��2022-2026��(nian)CAGRΪ16%�������(du)Һ��(dui)TSV����(neng)������(zhong)Ҫ(yao)��
ǰ�����(he)�Ĺ�Ӧ���ſ˿Ƽ��������չ���(han)��ǰ���峧��UPChemical��LG��̽���ҵ����Cotem��(cheng)ΪSK��(hai)��ʿ��LGƷʾ(shi)�ĺ�(he)�Ĺ�Ӧ�̣�����ſ�Ҳ�ѽ���Ϸʳ�(chang)�Ρ���(chang)���洢��������(fang)�ȹ�����ͷ�ͻ���������оƬ��ԱHBM����SK��(hai)��ʿ��ΪHBM�����ҵ��2022��(nian)6��������ʼ����HBM3��Ԥ��(ji)��2022Q3��Ӣΰ��H100ϵͳ��ӦHBM3��UPChemical��ΪSK��(hai)��ʿǰ�����(he)�Ĺ�Ӧ�̣���(you)�����(fen)���档
���������ҵ��40��(nian)����(lian)���²ģ���Ҫ(yao)��Ʒ�����ᾧ���ۡ����ڹ��ۡ���(qiu)�ι��ۡ���(yang)������/��(zhen)״�ۣ�����low-����(qiu)���low-����(qiu)����3D��(feng)װ�ؼ�(jian)ԭ����GMC����(ke)��״����(yang)�ܷ�(feng)�ϣ��������ϡ�
����(hai)�Ͽ���������(zi)����(yang)�ܷ�(feng)�ϴ������̣�����(hai)�ϿƳ�(cheng)����2010��(nian)����Ҫ(yao)��ƷΪ����(yang)�ܷ�(feng)�Ϻ͵��ӽ������ǹ��ڶ���(shu)�߱�оƬ�������Һ���(feng)װ�����з�����������רҵ��������˾���ܸ������η�(feng)װ��������(jin)һ(yi)��(nian)�ֳ�(cheng)�з���lowCTE2�����Ͷ�(dui)��������ճ���Լ�������������չ��������������������(yang)�ܷ�(feng)�ϲ�Ʒ��
����(zai)�ȱ���(feng)װ���룬��˾������QFN�IJ�Ʒ700ϵ���Ѿ�����(chang)��Ƽ���ͨ��(fu)��������ͻ���֤�����(cheng)С�������������ۣ���(cheng)Ϊ��˾�µĹ�������(chang)��(dian)���������ȱ���(feng)װ�Ŀ�(ke)��״����(yang)�ܷ�(feng)�ϣ�GMC����FC������Ѿ����ͻ���֤��Һ̬�ܷ�(feng)���ϣ�LMC��������(zai)�ͻ���֤���̵��У���(you)����(jian)��(jian)���(cheng)��ҵ����������(wai)��(zi)���̵�¢�ϵ�λ��